
江刺 正喜
半導体微細加工によるMEMS(Micro Electro Mechanical Systems)技術を用いると、高度なセンサなどが安価に製造でき、これらはIoTのキーデバイスとなっている。ここでは装着に適した構造の半導体イオンセンサについて述べる。
1.半導体イオンセンサ(装着に適した構造)
47年前の大学院生の時(1971年)に研究した、ISFET(Ion Sensitive Field Effect Transistor)と呼ばれる半導体イオンセンサを紹介する。電解液中の特定のイオンの濃度を計測するには、図1左に示すイオン選択性電極が使われている。水素イオン濃度であるpHを測るガラス電極はその代表例であるが、イオン感応層であるガラスと液の界面電位がpHで変化し、その電位はガラス膜を通して測定されるため、小型化すると高抵抗になる問題があった。ISFETの場合は図1右のように絶縁ゲートFETのゲート絶縁膜上にあるイオン感応層表面で生じる電位を、FETで電流に変換するため、小形化に適している。水素イオンの場合にはイオン感応層表面のSi-OH基が液中の水素イオン濃度に対応して、酸性の場合には Si-OH2+にアルカリ性の場合にはSi-O–に、それぞれ電荷を持ち界面電位を生じる。どのイオンに選択的に応答するかはイオン感応層表面組成により以下のような機構で変わり、表面にSi-Al-O–基を持つアルミノシリケートをイオン感応層に用いるとNa+イオンに応答する。Si-O–基の場合は電界が強いため、H+イオンを水和した状態から分離させて結合しpHセンサとして働く。これに対しSi-Al-O–基の場合にはSi-O–基よりも負電荷が分散し電界が弱いためにH+イオンは水和状態にあるが、水和エネルギの弱いNa+イオンはSi-Al-O–基と結合することができてpNaセンサとなる。これを利用しpHとpNaを測れるマルチイオンセンサ用ISFETも製作されている1)。
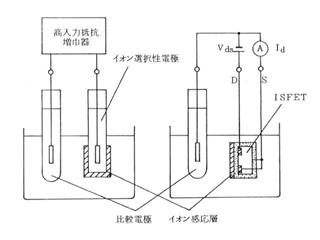

カテーテル先端に取り付けて体内でpHを測るため、MEMS技術で図2のような幅0.5mmのプローブ構造に製作した2)。先端にあるFET構造のセンサから、ソース・ドレインをSi内部に埋め込んだ拡散層を通して根本の端子部まで引き出しているが、これによって先端部だけがセンサとして機能する。端子部を樹脂で固定して図3のような形で外径1mmのカテーテル先端に装着し、pH用やPCO2(血管内炭酸ガス濃度)用のセンサとして製作した3)。pH用の表面はハイドロゲルで被覆し、血管内でも血栓ができないようにしている。PCO2センサの場合には、シリコーン樹脂によるガス透過膜の内部にNaHCO3を含むハイドロゲルを有し、CO3によるそのpH変化を測定する。pHとPCO2を血管内で連続モニタすることもできるが、臨床用となると血管内ではセンサを校正できないため信頼性を確保しにくい。1981年に薬事法の認可を受けて1983年に商品化され(図4)、逆流性食道炎の診断などに使われた。この他携帯用pH計としても食品関係などに使われており、2017年2月には電気学会の「電気の礎」として顕彰された。
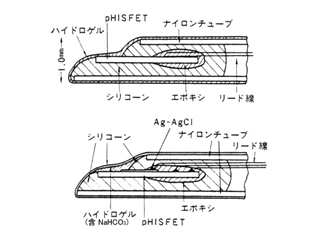

2.ウェハレベルパッケージングによる圧力センサ(センサ+(回路)+パッケージ)
センサの多くは測定対象に装着して使われるが、圧力センサの場合は圧力以外の影響を受けないようにセンサを外部から保護する必要がある。このためのパッケージングは、センサの安定性だけでなく小形化や低コスト化にも重要な要素で、これをウェハ状態で行うウェハレベルパッケージングが有効である。
シリコンに形成した薄いダイアフラムが両側の圧力差によって変形するのを検出するのに、ダイアフラムに加わる歪を抵抗変化として検出するピエゾ抵抗型と、ダイアフラムと対抗電極との間隔を静電容量変化として検出する静電容量型がある。
図5はウェハレベルパッケージングによるピエゾ抵抗型圧力センサの写真と製作工程である4)。N型のシリコンウェハに、ピエゾ抵抗用のp+型拡散層を形成する。これに穴の開いたガラスを陽極接合するが、これは400℃でガラスに-500V程の電圧を印加すると、静電引力により界面で共有結合する方法である。ガラスの孔に配線取り出し用の金属を堆積させた後、裏面のシリコンをエッチングして薄いダイアフラムを形成する。その後リード線を取り付けた後、1.5mm角の各チップに分割して完成する。図5の左上のようにガラスを通してみるとニュートンリングが見えるが、これは大気圧下で接合した時の温度Tが670Kで、室温(270K)にするとボイル-シャルルの法則(PV=nRT)よって、圧力Pが約0.4気圧と減圧になってダイアフラムが変形していることによる。この圧力センサは補助人工心臓に取り付けて血圧を連続モニタするのに用いられた5)。
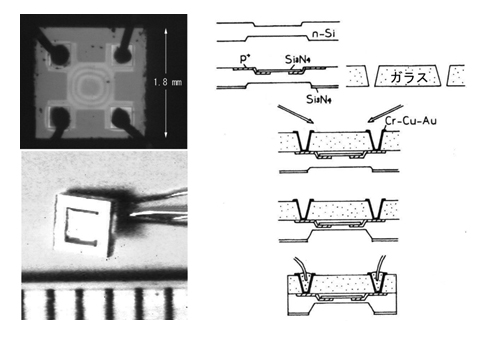
このウェハレベルパッケージングを用いると、チップに分割するときにセンサ部が保護されて信頼性が上がる。チップサイズのセンサを封止された状態で得られだけでなく、容器や組み立て装置が不要になり3割ほどのコストで実現できる。このためいろいろなセンサなどに用いられている6)。
図6はウェハレベルパッケージングによる集積化容量型圧力センサである7)。この集積化容量型圧力センサでは、圧力によるダイアフラムの変位による微小な静電容量を検出するため、容量検出用のCMOS集積回路を内部に形成してある。図7のような原理で、この容量検出回路によって出力周波数がセンサ容量で変化する。この周波数は、2本の電源線だけでその電流変化として測ることができ、また温度や電源電圧の影響を受けないように作られている。このセンサは微圧用センサとして実用化され、エアコンのフィルタにおける目詰まり検出などに用いられた8)。

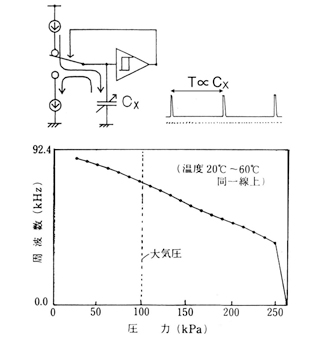
次回に続く-
参考文献
1) M.Esashi and T.Matsuo,Integrated micro multi ion sensor using field effect of semiconductor,IEEE Transactions on Biomedical Engineering,BME-25,2(1978)184-192
2) M.Esashi and T.Matsuo,Biomedical cation sensor using field effect of semiconductor,J.of the Japan Soc.of Applied Physics,44,Supplement(1975)339-343
3) K.Shimada,M.Yano,K.Shibatani,Y.Komoto,M.Esashi and T.Matsuo,Application of catheter-tip I.S.F.E.T.for continuous in vivo measurement,Med.& Biol.Eng.& Comput.,18,11(1980)741-745
4) M.Esashi,Y.Matsumoto and S.Shoji,Absolute pressure sensors by air-tight electrical feedthrough structure,Sensors and Actuators,A21-A23(1990)1048-1052
5) S.Nitta,Y.Katahira,T.Yambe,T.Sonobe,H.Hayashi,M.Tanaka,N.Sato,M.Miura,H.Mohri and M.Esashi,Micro-pressure sensor for continuous monitoring of a ventricular assist device,The International Journal of Artificial Organs,13,12(1990)823-829
6) M.Esashi,Wafer level packaging of MEMS,J.of Micromechanics and Microengineering,18(2008)073001(13pp)
7) 松本佳宣,江刺正喜,絶対圧用集積化容量形圧力センサ,電子情報通信学会論文誌C-II,J75-C-II,8(1992)451-461
8) T.Nagata,H.Terabe,S.Kuwahara,S.Sakurai,O.Tabata,S.Sugiyama and M.Esashi,Digital compensated capacitive pressure sensor using CMOS technology for low pressure measurements,Digest of Technical Papers Transducers’91,San Francisco,USA(1991)308-311
【著者紹介】
江刺 正喜(えさし まさよし)
東北大学 名誉教授
■略歴
昭和46年東北大学工学部電子工学科卒。51年同大学院博士課程修了。
同年より東北大学工学部助手、56年助教授、平成2年より教授となり、現在名誉教授。
東北大学 マイクロシステム融合研究開発センター(μSIC)センター長。
半導体センサ、マイクロマシニングによる集積化システム、
MEMS(Micro Electro Mechanical Systems)の研究に従事。
受賞:
電子通信学会業績賞(昭和55年)、日本IBM科学賞(平成5年)、SSDM Award(平成13年)、第3回産学官連携推進会議文部科学大臣賞(平成16年)、紫綬褒章(平成18年)他
