

1. はじめに
スマートファクトリー化の一環として、製品の形状検査は接触式測定から非接触式の光学測定へ置き換えが進められている。これにより、従来抜き取り検査で行われてきた製品の形状測定をインラインで、かつ全数検査とすることが可能となる。更に省人化や生産性の向上も期待できる。光学測定による非接触・非破壊検査の手法には、白色干渉法やOCT(Optical Coherence Tomography)など種々の干渉計測法があるが、これらの手法は数µm~数mmの測定レンジでnm~µmオーダーの高精度測定が実現できる特長を持つ。このため、小面積で浅い深度に対する近距離・高精度測定に適している。反面、対象物がcm~mオーダーの大面積である場合、一度に測定できる狭い範囲に分割して対象全体を少しずつ測定するため、時間や手間がかかる。大面積の測定対象物に対して、測定レンジ、測定精度共に最適な手法がOFDR(Optical Frequency Domain Reflectometry)である。本手法はFMCW(Frequency Modulated Continuous Wave)法としても広く知られている技術である。波長掃引光源を用いた干渉計測法であるOFDRは、測定対象物からの反射光と参照光との間で生成される干渉信号から、測定対象物までの距離を高精度に測定する手法であり、数cm~数mまでの距離を数µmの精度で測定可能である。その特長からLiDAR(Light Detection And Ranging)向けなどへの応用が進められている。ここで利用される波長掃引光源は、測定に要求される分解能や速度によって、適切な仕様の光源を選択する必要がある。例えば、高い位置分解能を得るためには、波長掃引幅が広い光源を必要とし、高速に移動する対象物の位置に応答して測定するためには、波長掃引周波数の高い光源が必要である。また、測定可能範囲を広げるためには可干渉距離(コヒーレンス長)の長い光源を選択する必要がある。高コヒーレントな光源を用いることで、OFDRの干渉信号を高いSNR(Signal to Noise Ratio)で測定でき、位置分解能や測定精度を向上させることもできる。
当社では高コヒーレントな波長掃引光源を開発し、販売を行っている(AQA5500P、AQB5500P、AQA5500D、AQB5500D)1)。本波長掃引光源は、MEMS(Micro Electro-Mechanical System)スキャニングミラーとグレーティングを用いたリットマン型の外部共振器レーザーであり、下記の特長をもつ2),3)。
① kHzオーダーの高速波長掃引(AQA5500P、AQA5500Dの場合)
② 単一縦モードの狭線幅レーザーによる高コヒーレンス性
③ モードホップ(波長跳び)がない連続的で、かつ広い波長掃引幅
本稿では、当社が開発した波長掃引光源の製品仕様について説明した後で、本波長掃引光源を利用したOFDRによる形状計測について基本原理および実測例を示す。
2. 波長掃引光源の製品仕様
当社製波長掃引光源の外観写真を図1に、主な製品仕様を表1にそれぞれ示す。卓上据置きでの使用を想定したBench topタイプ(図1(a))と、ユーザー機器への組み込み用途を想定したBuilt inタイプ(図1(b))の2機種を製品ラインナップとして準備した。また、市場からのさまざまな測定用途に対応するため、波長掃引速度1250 Hz品と150 Hz品の2機種を開発した。
本器は主に、MEMSスキャニングミラーを用いた波長掃引光源モジュールと、同光源モジュールを駆動するための制御基板から構成される。Bench topタイプでは、光源モジュール、制御基板の他に、筐体内部に冷却用のファンを設け、使用環境温度範囲内における特性の安定化を図った。Built inタイプでは、ユーザー機器への組み込みを基本コンセプトとしているため、外装筐体と冷却用ファンをなくし、ユーザー機器の構成に整合できるような実装形態を提供した。
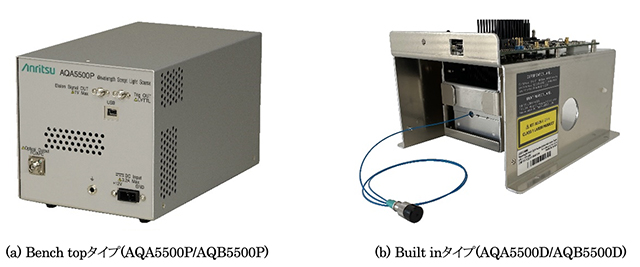
| 項目 | 仕様 | 備考 | |||
|---|---|---|---|---|---|
| 形名 | AQA5500P | AQB5500P | AQA5500D | AQB5500D | |
| 使用形態 | Bench topタイプ (卓上据置き用途) |
Built inタイプ (組み込み用途) |
|||
| 外観 |  |
 |
|||
| 寸法 | 137.4(W) ×131.4(H) ×219.4(D) mm | 160(W) ×118.6(H) ×175(D)mm | 突起部は除く | ||
| 光学的特性 | |||||
| 掃引中心波長 | 1550±5 nm | AQA5500P/AQA5500D:110nm掃引時 AQB5500P/AQB5500D:70nm掃引時 |
|||
| 波長掃引幅 | 30~110 nm | 15~70 nm | 30~110 nm | 15~70 nm | 設定分解能:1 pm USB経由にてPC上のソフトウェアより設定可能 |
| 掃引周波数 | 1250±50 Hz | 150±20 Hz | 1250±50 Hz | 150±20 Hz | 固定値であり調整不可 |
| 平均光出力 | ≧10 mW | CW出力 Class1(IEC 60825-1:2014) |
|||
3. OFDRの基本原理
本章では、波長掃引光源を用いたOFDRの基本原理について説明する。図2に、OFDRの基本構成を示す。
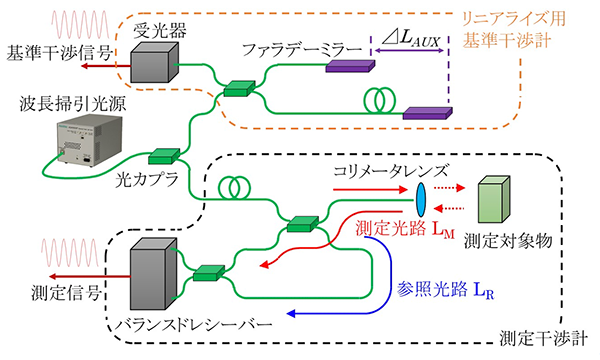
波長掃引光源から出力された光は、光カプラによりリニアライズ用基準干渉計と測定干渉計に分岐される。測定干渉計では、再び光カプラにより、参照光路LRと測定光路LMに分岐される。参照光路に分岐された光は、合波用の光カプラに入射される。測定光路に分岐された光は、コリメータレンズから空間中に放射される。空間中に放射された光は、測定対象物で反射され、再びコリメータレンズを通過後、合波用の光カプラに入射される。参照光路と測定光路からのそれぞれの光は合波用の光カプラで合波後、バランスドレシーバーで電気信号に変換される。参照光路と測定光路の両光路では光路長が異なるため、それぞれの光路を通過した光が受光器で合波されたとき、光路長差に応じた周波数の干渉信号が出力される。波長掃引光源から出力された光が、参照光路を通って受光器まで到達する光路長(図2中の青色実線)と、測定光路を通ってコリメータレンズに到達し、コリメータレンズから受光器まで到達する光路長(図2中の赤色実線)が一致するように光ファイバ長を調整することで、受光器から出力される干渉信号には、コリメータレンズから測定対象物までの距離の情報が含まれることになる。干渉信号をサンプリングした後、FFT(Fast Fourier Transformation)を施せば、測定対象物までの距離に応じた周波数の位置にピークが観測されることで、コリメータレンズから測定対象物までの距離が分かる4),5)。
一方、リニアライズ用基準干渉計に分岐された光は、ファラデーミラーで反射された後、光路長差ΔLAUXに応じた周波数の基準干渉信号として受光器から出力される。リニアライズ用基準干渉計は、波長掃引の非線形性を補正するために利用される。時間に対する掃引波長の変化率が線形である場合、測定干渉計から出力される干渉信号の周波数は一定であり、FFTの演算結果もその周波数に応じた位置にのみピークが得られる。しかし一般には波長掃引光源から出力される光の周波数は時間に対して非線形であるため、干渉信号の周波数は時間により変化する。そのため、FFT後のピークは幅広く観測される。結果として、ピーク位置を正確に判別することが困難となる。そこで実際の測定では、測定対象物を含んだ測定干渉計の他に、基準となる干渉計を用いてその非線形性の影響を補正することが重要となる4),5)。基準干渉信号の立上がりに合わせて測定信号をサンプリングすることで、非線形性の影響を補正することができる。
次回に続く-
参考文献
- アンリツ㈱、”波長掃引光源(Wavelength Swept Light Source)”、https://www.anritsu.com/ja-JP/sensing-devices/products/swept-light-source
- K. Nakamura, S. Morimoto, and T. Nakayama, “Single-Mode and Mode-Hop-Free Wavelength Sweep Light Source with Range of Over 160 nm and High Swept Frequency,” IEEE Photonics Technology Letters, Vol. 22, No. 19, Oct. 2010.
- 中村賢一,腰原勝,斉藤崇記,川北浩二,“高コヒーレンス波長掃引光源”,アンリツテクニカル,No.92, pp.35-39 (2017.3)
- 斉藤崇記,“OFDRによる3次元形状測定”,アンリツテクニカル,No.95, pp.28-34 (2020.3)
- 腰原勝,斉藤崇記,“高コヒーレンス波長掃引光源を用いた光干渉計測”,アンリツテクニカル,No.97, pp.35-44 (2022.3)
【著者紹介】
腰原 勝(こしはら まさる)
アンリツ株式会社 センシング&デバイスカンパニー 開発本部 第1開発部 主任
■略歴
2005年 法政大学大学院工学研究科情報電子工学専攻 修了。
同年、アンリツ㈱入社
その後、光計測器や波長掃引光源など、機器製品の設計開発業務に従事
現在に至る
斉藤 崇記(さいとう たかのり)
アンリツ株式会社 センシング&デバイスカンパニー 開発本部 第1開発部 主席研究員
■略歴
1988年 東京都立大学大学院理学研究課程物理学専攻修了。
同年アンリツ株式会社入社。
1993年 神奈川科学技術アカデミー大津「フォトン制御」プロジェクト派遣研究員。
光周波数コム発生器の研究に従事
1996年 アンリツ株式会社に復帰
1998年 東京工業大学より学位授与(工学博士)
現在、アンリツ株式会社センシング&デバイスカンパニー主席研究員。
ファイバセンシング、OFDRによる3次元形状測定等の研究に従事

