
理工学部 特任教授
木股雅章
1. はじめに
MEMS (Microelectromechanical Systems) 技術は、LSIと同じようなプロセス装置を使って三次元構造を作る製造技術である。MEMS技術は他の技術では実現できない機能や性能をもったデバイスを数多く市場に送り出してきた。非冷却赤外線イメージセンサもそうしたデバイスの一つで、MEMS技術の特長を有効に活用して発展してきた。過去30年間の非冷却赤外線イメージセンサの進歩は、MEMS技術に支えられてきたと言っても過言ではない。
ここでは、MEMS技術が非冷却赤外線イメージセンサの開発の中で果たした役割を振り返るとともに、現状と今後について考える。
2. 熱型赤外線検出器
図1に非冷却赤外線イメージセンサに使用されている熱型赤外線検出器の基本構造と構成要素の働きを示す。受光部は赤外線吸収層と温度センサからなり、断熱構造で基板と繋がっている。熱的にヒートシンクとして働く基板の上には信号読出回路が形成されている。
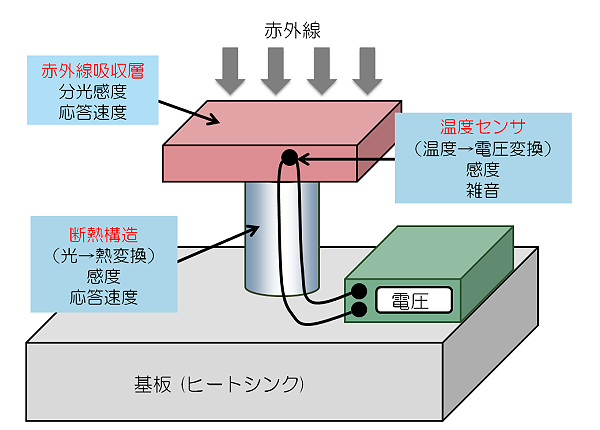
熱型赤外線検出器は、受光した赤外線のエネルギーを熱に変換し、受光部の温度変化として赤外線を検出する。受光部が温度変化して受光部と基板の間に温度差できると、熱流が生じる。単位時間あたり移動する熱量は、受光部と基板の間の温度差に比例し、断熱構造の熱コンダクタンスに反比例する。定常状態では、単位時間あたりに移動する熱量と受光部が吸収する赤外線エネルギーが等しくなるので、一定の赤外線入射に対する受光部の温度変化は、熱コンダクタンスに反比例する。温度センサは、受光部の温度変化を電圧に変換する。熱型検出器の感度は、受光部の温度変化と、その温度変化に対する温度センサの出力の大きさで決まるので、熱コンダクタンスに反比例し、温度センサの感度に比例する。
熱型赤外線検出器の応答速度は、受光部の温度変化の時定数(熱時定数)で決まる。熱時定数は受光部の熱容量と熱コンダクタンスの比で決まる。熱容量が一定の場合、熱コンダクタンスを小さくすると感度は高くなるが、応答速度の悪化を招くので、感度と応答速度はトレードオフの関係にある。通常、非冷却赤外線イメージセンサは自然な動画が得られるよう熱時定数が10 ms程度になるように設計されている。
熱型赤外線検出器の分光感度特性(感度の波長依存性)は、赤外線吸収層の吸収率の波長依存性で決まる。非冷却赤外線イメージセンサに用いられる赤外線検出器には、8~14 μmの波長範囲で高い吸収率が得られる赤外線吸収層が用いられる。赤外線吸収層は受光部の一部であるので、熱時定数の観点から低熱容量であることが要求される。
熱型赤外線検出器の温度センサの雑音は性能を決める重要な要因になる。非冷却赤外線イメージセンサでは、特に1/f雑音が問題になることが多い。
3. 開発初期にMEMS技術が果たした役割
MEMS技術は非冷却赤外線イメージセンサが実用段階に入った1990年前後に非常に重要な役割を果たした。ここでは、開発初期にMEMS技術が果たした役割を概観する。
図2に非冷却赤外線イメージセンサ開発初期の感度改善の状況を模式的に示した。図中のグラフは、画素ピッチを50 μmとして熱型検出器の感度をモデル計算した結果で、横軸は断熱構造の熱コンダクタンスで、縦軸は相対感度である。
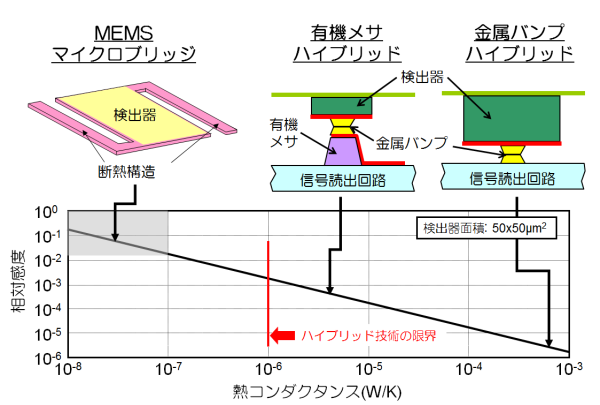
1980年代後半まで、非冷却赤外線イメージセンサの画素構造は、図2の右上に示す金属バンプハイブリッド構造であった。この構造は、別チップとなっている検出器と信号読出回路を金属バンプで画素ごとに電気接続したものである。この場合、図1の断熱構造に相当するのが金属バンプとなるので、熱コンダクタンスは10-4 W/K台であった。この構造は高熱コンダクタンスのため十分な感度を得ることはできなかったが、1990年代に入り図2の中央上のような有機メサを含むハイブリッド構造が開発され、熱コンダクタンスは2桁以上低減され、実用化レベルの感度が達成された。
有機メサハイブリッド構造の開発は、非冷却赤外線イメージセンサの研究開発の歴史の中で革新的なものであったが、図2に示したように、この延長線での性能改善には限界が見えていた。こうした状況で非冷却赤外線イメージセンサの製造にMEMS技術を導入することが試みられ大成功を収めた1)。図2に示したように、MEMS技術で製造されるマイクロブリッジ構造を用いると熱コンダクタンスを10-7 W/K以下に低減することができたので、ハイブリッド構造の限界より1桁以上高い感度が得られるようになった。
図3にMEMS技術で製造される非冷却赤外線イメージセンサと画素の構造を示す。マイクロブリッジ画素では、受光部は2つの支持脚(図1の断熱構造に相当)で支えられており、受光部と基板表面の間には空間が形成され、支持脚はアンカーの部分で基板と接している。支持脚の熱コンダクタンスは細長い形状とすることで小さくすることができる。非冷却赤外線イメージセンサは、シリコン信号読出回路の上にマイクロブリッジ画素を2次元配列したモノリシック構造で、LSIプロセスで信号読出回路を形成したのちMEMSプロセスを経て完成する。この製造プロセスは多数の素子を載せたウエハの形で行うことができる。
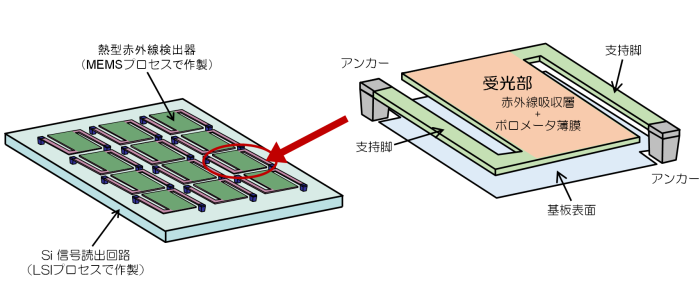
以上のように、MEMS技術は性能と生産性の両面で非冷却赤外線イメージセンサの開発初期に非常に重要な役割を果たした。
次回に続く-
1) 1) R. A. Wood, et al., Tech. Dig. IEEE Solid-State Sensor and Actuator Workshop, pp. 132-133 (1992).
【著者紹介】
木股 正章(きまた まさふみ)
立命館大学 理工学部 特別任用教授
■略歴
1976年 名古屋大学大学院工学研究科修士課程修了。同年 三菱電機株式会社入社。
2004年 三菱電機株式会社退社。同年 立命館大学理工学部教授。1980年より現在まで赤外線イメージセンサの研究開発に従事。
2009年よりJAXAのType-II超格子赤外線センサの開発に参画。電気学会、日本赤外線学会、応用物理学会、IEEE会員、SPIEフェロー。
2013~2014年 日本赤外線学会会長。
2016年 立命館大学退職。同年 立命館大学理工学部特任教授。
1988年 市村賞貢献賞、1993年 全国発明表彰内閣総理大臣発明賞、2016年 日本赤外線学会業績賞などを受賞。工学博士。

